Nous avons travaillé dans le cadre de notre projet recherche technologique en 5ème année sur un sujet qui relie l’instrumentation, la physique, la métrologie et le traitement du signal.
Enfin, nous sommes dans la dernière ligne droite en cinquième année. Mais cette dernière année d’un élève ingénieur INSA Strasbourg en génie électrique rime aussi avec un projet qui relie technologie et recherche. Le choix de ce projet est important, car il va occuper une grande partie du temps. Ces sujets peuvent traiter de différents thèmes en recherche & développement. Dans notre cas, l’intitulé d’un des sujets sortait vraiment du lot : « La microscopie interférométrique en lumière blanche ». C’est un sujet à l’interface de la recherche et des sciences pour l’ingénieur. Participer à un projet en lien avec la recherche scientifique est motivant pour un jeune ingénieur en début de carrière.
Nous travaillons sur la plateforme de physique et vibration de l’INSA. Bien que ce soit un laboratoire prévu pour l’enseignement, les enseignants-chercheurs de cette plateforme participent à la recherche du laboratoire ICube dans le groupe Instrumentation et procédés photoniques. Plusieurs microscopes ont été développés dans cette équipe. Mais tous ces microscopes ne sont pas utilisés de la même façon. Ainsi, il peut être intéressant de comparer les techniques pour trouver la plus efficace pour un échantillon et/ ou une application en particulier.
Le sujet aborde un thème nouveau pour nous. Les compétences attendues restent celles d’un d’ingénieur en génie électrique. A savoir analyser et comprendre les limites du matériel, et développer un programme permettant l’acquisition et le traitement des données. Revenons à l’intitulé du sujet, à savoir la microscopie interférométrique en lumière blanche. C’est une technique de microscopie optique, utilisant l’aspect ondulatoire de la lumière, afin de pouvoir déterminer principalement le profil d’une surface (topographie). Dans le cadre de notre projet, ce sont les interférences d’une onde électromagnétique qui vont nous intéresser. Pour bien comprendre l’interférométrie, observons la Figure 1 qui présente une image obtenue avec notre montage : on visualise très bien des franges (ce sont des raies sombres et des raies claires). Ces franges apparaissent grâce à un objectif dit de Mirau utilisé pour la microscopie : c’est un objectif qui contient un petit interféromètre.

Figure 1: Franges sur un échantillon de silicium

Figure 2: Observation des franges sur une zone marquée de l’échantillon
Sur la figure 2, dans la zone entourée en rouge, une frange traverse une zone marquée au laser sur une plaque de silicium. Ce marquage déforme localement la frange. Cette déformation se caractérise par une modification de la phase en cet endroit. A l’aide d’un algorithme appelé PSM (Phase Shift Algorithm), on peut analyser cette différence de phase lors du déplacement des franges et reconstruire la topographie de la surface. Ce type de microscopie est parfaitement adapté pour voir un état de surface de façon précise (résolution maximale de 10nm).
Réalisation
Pour le matériel, nous avons à notre disposition, un PC pour le traitement et le contrôle avec le logiciel LabVIEW, un bâti optique simplifié avec son support et un objectif de Mirau et un contrôleur pour la source lumineuse LED du microscope (voir figure 3).
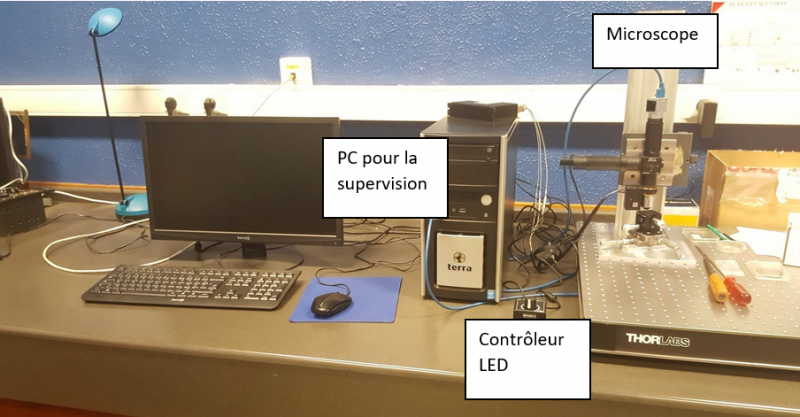
Figure 3: Ensemble du matériel à notre disposition pour le projet
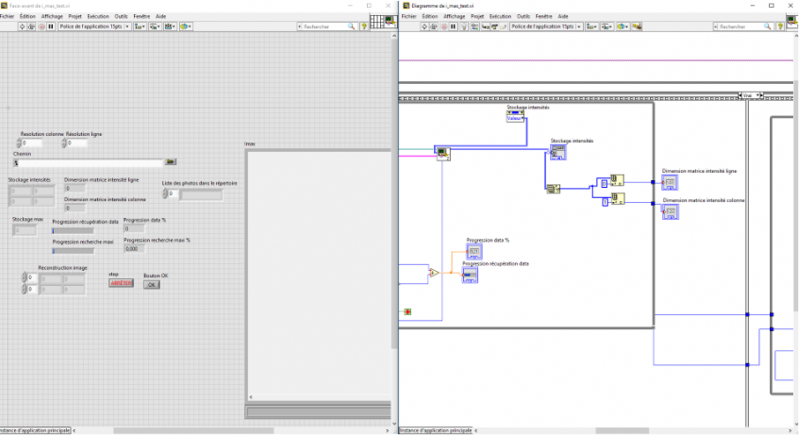
Figure 4 : Extrait d’un programme LabVIEW (mesure Imax)
Pour réaliser ce projet, on utilise une suite logicielle appelée LabVIEW. L’environnement permet de faire une interface graphique adaptée à de nombreuses applications. Dans notre cas, nous souhaitons principalement visualiser des images et des graphiques (voir figure 4).
Les différentes parties du programme :
- Déplacement du piézoélectrique
- Acquisition d’images
- Configuration de la caméra
- Mesure de la longueur d’onde effective
- Traitement des acquisitions par la PSM
- Topographie des échantillons avec la PSM
- Traitement des acquisitions pour Imax
- Topographie des échantillons avec la PFSM
- Amélioration de la qualité des images en retirant les composantes non souhaitées (bruit thermique et poussières)
Ces grandes fonctions sont « les briques » de notre programme. On retrouve l’assemblage de ces fonctions sur notre programme principal.

Figure 5: Plaque de silicium

Figure 6: Capture du panneau de contrôle du programme pour la PSM
L’interface de la figure 6 réalise l’acquisition et le traitement des images. Elle affiche ensuite la topographie de l’échantillon visualisé. L’échantillon affiché sur l’interface est une plaque de silicium marquée au laser (voir figure 5).

Figure 7: Image de synthèse représentant la phase
La figure 7 est la représentation visuelle d’une image de phase après l’application de la première partie de l’algorithme PSM. On constate très bien les problèmes de discontinuités. On distingue la marque faite par un laser entre deux discontinuités. Pour corriger ce défaut, on applique une méthode appelé la « reconstruction du front d’onde » ou déroulage de la phase (voir figure 8).
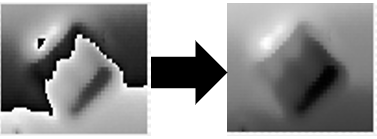
Figure 8: image de synthèse de la phase (zone marquée au laser) avec correction des discontinuités
On peut ensuite appliquer la dernière partie de l’algorithme pour établir une topographie de l’échantillon.

Figure 9 : Topographie de l’échantillon de silicium
Grâce à cette image (Figure 9), on peut visualiser l’état de surface de l’échantillon et réaliser des mesures de rugosités. Cette méthode est adaptée pour l’analyse de défauts d’une profondeur très faible, afin de mesurer une rugosité de surface. Des erreurs peuvent donc apparaître sur la topographie lors de la correction des discontinuités. Cependant, on visualise très bien le marquage au laser sur l’échantillon de la figure 5.
Nous avons également développé une fonction permettant la mesure de la longueur d’onde effective de la source lumineuse (voir figure 3). Le segment rouge visible sur la figure 10 représente la longueur d’onde effective. La différence de position nous donne cette valeur.

Figure 10 : vue en détail de l’interférogramme
La différence des positions est d’environ 6650-6050=600nm. La précision de la mesure va dépendre du nombre d’images acquises (215 photos pour l’exemple). La longueur d’onde effective dépend du maximum du spectre de la source et du montage optique. Cette fonctionnalité permet de pouvoir configurer correctement la PSM.

Figure 11 : Échantillon de silicium traité
A partir du stack d’image utilisé pour la mesure de la longueur d’onde effective, on peut obtenir une image appelée Imax : c’est une image dont la profondeur de champ est infinie, comme en microscopie confocale. C’est une image reconstruite par ordinateur, en récupérant l’intensité maximale de chaque pixel sur un même relevé.
Pour se faire, nous avons utilisé l’échantillon en figure 11. On peut voir ce même échantillon au microscope en figure 12.
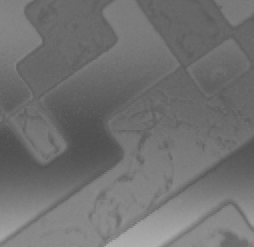
Figure 12: Échantillon de silicium balayé par les franges pour le relevé de Imax
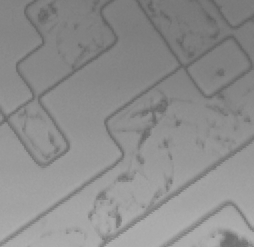
Figure 13 : Imax
En figure 13 on obtient l’image la plus nette possible : elle permet d’apprécier au mieux les détails d’un échantillon.
Nous allons à partir de cette image, reconstruire le profil topographique de l’échantillon. Chaque maximum renvoie à une altitude précise. Nous allons reconstruire une autre image à partir de ces altitudes (voir figure 14).

Figure 14: Image topographique de l’échantillon
Pour pouvoir le visualiser, nous sortons ces altitudes sur un graphique 3D (voir figure 15).
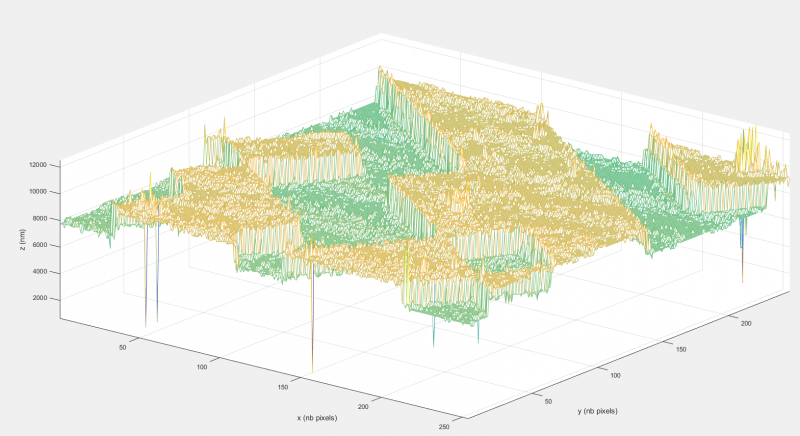
Figure 15 : Représentation 3D de la surface de l’échantillon
Nous avons maintenant la représentation de l’état de surface de notre échantillon. On peut distinguer très clairement les reliefs. Cette technique s’appelle la PFSM (Peak Fringe Scanning Microscopy). On utilise la frange la plus « brillante » (repérée pour l’acquisition de imax) et on balaye l’échantillon.
Application :
Les applications sont diverses : on va retrouver tout ce qui est une mesure d’état de surface (micro-électronique, étude des matériaux, biologie…). Toutefois, la mesure peut devenir complexe, notamment si les reliefs sont trop profonds et si l’échantillon est constitué de plusieurs matériaux avec des couches différentes.
Conclusion :
Le PRT nous permet de voir un autre domaine que les matières enseignées en cours. Il faut faire preuve de curiosité, d’ingéniosité et de travail. Une grosse majorité de ce que l’on a pu voir était nouveau pour nous. Nous avons pu apprendre de nouvelles choses, et surtout une méthode de travail pour aborder un sujet en relation avec la recherche. Bien entendu, nous n’étions pas seuls. Monsieur Manuel Flury et Monsieur Christophe Cordier nous ont bien aidé dans nos travaux. Nous souhaitons donc les remercier pour leur disponibilité et leur aide.
Anthony Cordonnier
Quentin Cuny
Vidéos:
Interférogramme et PSM:
Imax et PFSM:
Références:
Remy Claveau. Caractérisation spectrale locale à l’aide de la microscopie interférométrique : simulations et mesures [en ligne]. Thèse de doctorat en Science pour l’ingénieur, spécialité : Electronique, photonique et Microélectronique. Strasbourg : Université de Strasbourg, 2017, 223p. Format PDF. Disponible sur : < https://tel.archives-ouvertes.fr/tel-01730792/ >
Benatmane Abderrazzaq . Développement de la microscopie interférométrique pour une meilleure analyse morphologique des couches minces et épaisses des matériaux semiconducteurs et optiques [en ligne]. Thèse de doctorat en Science pour l’ingénieur, spécialiste : Instrumentation et Microélectronique. Strasbourg : Université Louis Pasteur, 2002, 195p. Format PDF. Disponible sur : <https://tel.archives-ouvertes.fr/tel-00002418/document>
Patrick Bouchareine : Interférences de la lumière – Théorie et applications. In : Techniques de l’ingénieur. Référence R6475V1 , 10 mars 2002. Disponible sur : <https://www.techniques-ingenieur.fr/base-documentaire/electronique-photonique-th13/fondamentaux-de-l-optique-42448210/interferences-de-la-lumiere-r6475/ >